
以 Ga2O3 氧化鎵為主的第四代半導體躍上檯面,將成為下一個明日之星,如何鑑定呢?
用氮化鋁鎵(AlGaN)磊晶為主要材料製造的深紫外光(deep ultraviolet, DUV)發光二極體(light-emitting diodes, LEDs)元件,其優異的光學性質和體積小的特性,逐漸取代水銀燈和氙氣燈,成為攜帶型生化檢查系統、淨水器、紫外光微影曝光機等的光源[1-3]。藉由各種改善磊晶層結構品質的方法,可以進一步增進現階段氮化鋁鎵(AlGaN)深紫外光發光二極體的光學性質[4, 5]。其中一個方法是在氮化鎵(GaN)和氮化鋁鎵(AlGaN)的側壁上引入一層奈米級氧化鎵(Ga2O3)磊晶層[6]。本期宜特小學堂,將呈現如何應用宜特材料分析實驗室的穿透式電子顯微鏡(TEM)分析技術鑑定俗稱第四代半導體-氧化鎵(Ga2O3)磊晶層的晶體結構,晶體形貌與組成。
為何氧化鎵(Ga2O3)被稱為第四代半導體?
氧化鎵(Ga2O3)被稱為第四代半導體的原因是,其超寬能隙的特性,相較於相較於第三代半導體(化合物半導體)碳化矽(SiC)與氮化鎵(GaN),將使材料能承受更高電壓的崩潰電壓與臨界電場。
一、 氮化鋁鎵深紫外光發光二極體元件結構
用有機金屬化學氣相沉積(Metal-organic Chemical Vapor Deposition, MOCVD),製作的氮化鋁鎵深紫外光發光二極體薄膜元件之剖面圖如圖一(a)所示。先在藍寶石(sapphire)基板上長一層氮化鋁(aluminum nitride, AlN)做為緩衝層,減少後續氮化鋁鎵磊晶層的差排缺陷,長上二層不同鋁濃度的氮化鋁鎵磊晶層後,再長上多重量子阱(multiple quantum well, MQW)層、電子阻擋層(electron-blocking layer, EBL)、氮化鎵(gallium nitride, GaN)等奈米磊晶層。
接下來用微影製程將此 MOCVD 製作的元件頂部蝕刻成如圖一(b)所示的平台形狀,然後在氧化氣氛的高溫中熱處理,使氮化鋁鎵磊晶層側壁和氮化鎵表面生成氧化物,最後再用磁控濺鍍(magnetron sputtering)法鍍上一層 100 奈米厚的高純度二氧化矽[7],如圖1一(c)所示。

▲圖一:氮化鋁鎵(AlGaN)深紫外光發光二極體元件的剖面圖示意圖。(a)MOCVD成長的二極體元件;(b)用微影製程蝕刻元件頂部形成平台後;(c)經氧化熱處理 + SiO2 鍍層後。[7](圖片來源:宜特科技)
二、 TEM 影像與電子繞射分析鑑定反應生成相
先用聚焦離子束(focus ion beam, FIB)在元件頂部選定的位置切割,製成橫截面型 TEM(cross-section TEM, X-TEM)試片[8],然後對一系列不同熱處理的氮化鋁鎵試片進行 TEM/STEM 影像分析和電子繞射,目的在鑑定氮化鋁鎵磊晶層側壁和氮化鎵表面形成的氧化物為何物。
圖二顯示二張中低倍率的 TEM 明場像,分別為原始氮化鋁鎵試片與 900ºC,20 分鐘熱處理的氮化鋁鎵試片的橫截面結構。仔細比較圖二 a 與圖二 b,可以發現熱處理後的試片,在氮化鎵層頂部和氮化鋁鎵層側壁共有三個新相(phases)產生,如圖二 b 中標示 1、2、3 的區域。
圖三中比較 900ºC,20 分鐘熱處理的氮化鋁鎵試片的 STEM 明場像和環形暗場像。綜合圖二和圖三中的 TEM 與 STEM 影像,宜特材料分析實驗室初步歸納出 STEM 環形暗場像是此材料系統的最佳影像分析技術。我們在將影像倍率再往上提高,進一步確認 STEM 暗場像在此材料系統的適宜性。
如圖四所示,STEM 環形暗場像,明顯比 STEM 明場像更清楚區分各新形成的生成物。從以上這些初步的影像資料中,生成物影像明暗對比的變化特性,推斷第一相和第三相為多晶,且晶粒大小只有數奈米,而第二相有可能為單晶結構。
 ▲圖二:TEM 明場像顯示氮化鋁鎵深紫外光發光二極體元件的橫截面結構。(a)MOCVD生長後,熱處理前;(b)900ºC/20 分鐘熱處理後。[8](圖片來源:宜特科技)
▲圖二:TEM 明場像顯示氮化鋁鎵深紫外光發光二極體元件的橫截面結構。(a)MOCVD生長後,熱處理前;(b)900ºC/20 分鐘熱處理後。[8](圖片來源:宜特科技)
 ▲圖三: 900ºC/20 分鐘熱處理後,氮化鋁鎵深紫外光發光二極體元件的橫截面結構。(a) TEM明場像;(b) STEM環形暗場像。(圖片來源:宜特科技)
▲圖三: 900ºC/20 分鐘熱處理後,氮化鋁鎵深紫外光發光二極體元件的橫截面結構。(a) TEM明場像;(b) STEM環形暗場像。(圖片來源:宜特科技)
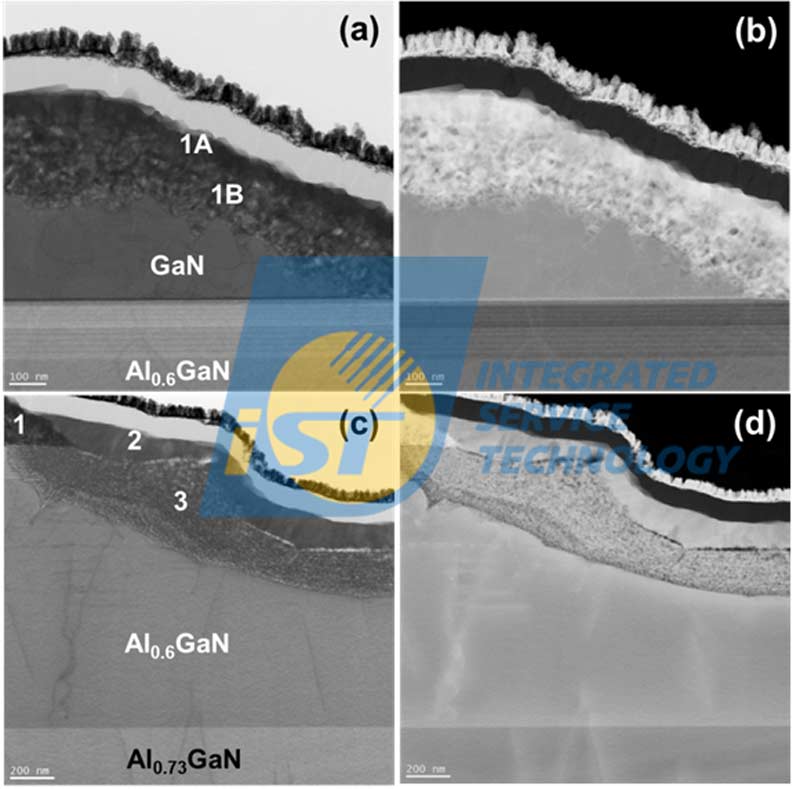 ▲圖四:二組中高倍率 STEM 影像顯示 900ºC/20 min,熱處理後二極體元件頂部與側壁的氧化層結構。(a)&(b)分別為 GaN 頂部與側壁的氧化層結構的 STEM 明場像和環形暗場像;(c)&(d)分別為 AlGaN 側壁的氧化層結構 STEM 明場像和環形暗場像。(圖片來源:宜特科技)
▲圖四:二組中高倍率 STEM 影像顯示 900ºC/20 min,熱處理後二極體元件頂部與側壁的氧化層結構。(a)&(b)分別為 GaN 頂部與側壁的氧化層結構的 STEM 明場像和環形暗場像;(c)&(d)分別為 AlGaN 側壁的氧化層結構 STEM 明場像和環形暗場像。(圖片來源:宜特科技)
圖五則顯示一組選區繞射圖案(selected area diffraction pattern, SADP)和一低倍率 STEM 明場像。這些 SADPs 分別對應氮化鎵層、氮化鋁鎵層、和三個生成物(圖 5a)。氮化鎵層和氮化鋁鎵層都是磊晶層(epitaxial layer),對應的 SADPs 指出 TEM 觀察方向都是 [1 1 -2 0] 極軸(zone axis)方向。三個生成物的 SADPs 目前尚未完全解出,但是其形貌都是單一組點狀繞射圖案,而且非常類似。此種形式的 SADPs 指出該分析區域是單晶,而且這些單晶的某個晶向都和氮化鎵層(氮化鋁鎵層)的 [0002] 晶向逆時針偏轉約 10 度。這個從 SADPs 的晶體分析結果和從圖三與圖四影像資料推論的晶體結果有所矛盾。
 ▲圖五: 900ºC/20 分鐘熱處理後,氮化鋁鎵試片的低倍率 STEM 明場像,與磊晶層的選區繞射圖案。(a)低倍率 STEM 明場像;(b)GaN 的 SADP,z = [11 -2 0];(c)AlGaN 的 SADP,z = [11 -2 0];(d)第 1 相生成物的 SADP;(e)第 2 相生成物的 SADP;(f)第 3 相生成的 SADP。(圖片來源:成功大學賴韋志教授)。
▲圖五: 900ºC/20 分鐘熱處理後,氮化鋁鎵試片的低倍率 STEM 明場像,與磊晶層的選區繞射圖案。(a)低倍率 STEM 明場像;(b)GaN 的 SADP,z = [11 -2 0];(c)AlGaN 的 SADP,z = [11 -2 0];(d)第 1 相生成物的 SADP;(e)第 2 相生成物的 SADP;(f)第 3 相生成的 SADP。(圖片來源:成功大學賴韋志教授)。
針對前述 TEM/STEM 分析結果的矛盾,我們進行臨場 TEM/STEM 影像和電子繞射交互分析觀察,確定在氮化鎵層上方/側壁和氮化鋁鎵側壁,經高溫熱處理後產生的生成物都是單晶。第一相生成物和第三相生成物內的明暗變化,並非因為晶粒產生的繞射對比,而是試片本身密度變化產生的原子序對比。
從更高倍率的 STEM 環形暗場像,如圖六所示,我們更清楚辨認生成物為多孔性結構,暗色的區域(明場像中亮的區域)是空孔。第一相生成物空孔的尺寸明顯數倍大於第三相生成物空孔的尺寸,第二相生成物算是緻密的單晶結構,但其內仍有幾個大空孔,其中一個如圖六中白色箭頭指處。造成第一相生成物和第三相生成物為多孔性結構的原因,推測可能是熱處理溫度過高,氧和鎵與鋁的交互擴散速率高於生成物原子堆積速率所導致的結果。
一般來說,用電子繞射圖案解析晶體結構,必須從數個極軸方向的 SASPs 推算才能得到確定的結果。由於目前只有一個極軸方向的 SASPs,很難從這些有限的 SADPs 中明確地推算出生成物的晶體結構。從 SASP 模擬分析中發現 -Ga2O3 的 [0 1 0] SADP 和圖五(d, e, f)中的 SADP 很接近,因此初步推斷在 GaN 層上的生成物有可能是 -Ga2O3,而在 AlGaN 層上的生成物則有可能是 -(AlxGa1-x)2O3。由於 -Ga2O3 是單斜晶體,其 SADP 的分析工作將會複雜許多。
 ▲圖六: 900ºC/20分鐘熱處理後,氮化鋁鎵試片的高倍率 STEM 環形暗場像,解析生成物的顯微結構形貌。白色箭頭指處是一較大的空孔。[8](資料來源:宜特科技)
▲圖六: 900ºC/20分鐘熱處理後,氮化鋁鎵試片的高倍率 STEM 環形暗場像,解析生成物的顯微結構形貌。白色箭頭指處是一較大的空孔。[8](資料來源:宜特科技)
三、 STEM/EDS 分析-自我校正定量分析
圖七顯示一組由 STEM/EDS 能譜影像(spectrum image)技術,獲得的氮化鎵和生成物之元素映像圖(elemental maps)。這些元素映像圖顯示生成物的組成元素只有氧和鎵,意指此生成物是鎵氧化物。再用 EDS 軟體從二氧化矽層拉一垂直相界(phase boundary)的直線(圖八(a)中的淺藍色箭頭),通過氧化物到達氮化鎵層,算出沿此直線各元素的濃度變化。
圖八(b)顯示計算出來的結果,此計算結果是由 TEM 的 EDS 軟體用內存的 K 因子(K factors) [9-11],進行成份定量分析。這樣 EDS 定量分析方法稱為無標準試片定量分析法(standardless quantitative analysis),此方法計算的結果目前已廣泛被各種科學與工程類的論文期刊接受。
在圖八(b)的 EDS 直線濃度變化曲線(line profiles)內,對應氧化物 1B 的區段內,找出一平坦的區段,推算氧化物 1B 的成份,得到該氧化物的組成元素比(O/Ga)為 1.23,相當於化學式為 Ga5O6。這是 EDS 偵測器接收從試片發出的元素 X-光訊號,加上資料庫內的K因子後計算出的氧化物成分,然而文獻中沒有這種成份的氧化鎵。
當定量分析的元素包含碳、氮、氧等輕元素時,即使 TEM 試片屬薄片(thin foil)型試片,吸收效應仍然相當顯著,只是經常被忽略,造成相當大的誤差而不知覺。仔細檢查圖八(b)可以發現,在直線濃度變化曲線的左側二氧化矽區段中 O/Si 比值小於 2,而右側氮化鎵區段中 N/Ga 比值明顯小於 1。利用這二側已知成份的二氧化矽層和氮化鎵層,對此直線濃度變化曲線做自我校正(self-calibration)修正。
經修正後的直線濃度變化曲線如圖八(c)所示,此時從相同平坦區段推算的組成元素比(O/Ga)為 1.53,相當於化學式為 Ga2O3,符合文獻中報導的氧化鎵組成[12],也符合化學鍵價數的搭配。
在 TEM(STEM)/EDS 成份定量分析中,利用待分析物周圍已知成份的相,做自我校正計算,進一步提高 EDS 定量分析的準確度稱為「EDS 自我校正定量分析法(self-calibration EDS quantitative analysis)」,此技術是宜特實驗室自行開發的 TEM 材料成份分析技術之一,校正後的結果比只經由 EDS 內建軟體的計算結果準確許多。
主要的原因在於所有的 TEM/EDS 內建軟體都不考慮元素 X-光在 TEM 試片內的吸收效應。然而當 EDS 定量分析牽涉到碳、氮、氧等輕元素時,因這些元素的 X-光能量很小,吸收效應產生的誤差就變成相當明顯。對於含輕元素的化合物,透過 EDS 自我校正定量分析法,宜特材料分析實驗室的 TEM/EDS 定量分析結果比其他 TEM 分析實驗室更為準確。
 ▲圖七: 900ºC/20 分鐘熱處理試片的氮化鎵和氧化物的元素映像圖。(a)分析區域的 STEMBF 影像;(b)鎵元素映像圖;(c)氮元素映像圖;(d)氧元素映像圖;(e)矽元素映像圖;(f)綜合元素映像圖。[8] (圖片來源:宜特科技)
▲圖七: 900ºC/20 分鐘熱處理試片的氮化鎵和氧化物的元素映像圖。(a)分析區域的 STEMBF 影像;(b)鎵元素映像圖;(c)氮元素映像圖;(d)氧元素映像圖;(e)矽元素映像圖;(f)綜合元素映像圖。[8] (圖片來源:宜特科技)
 ▲圖八: 900ºC/20 分鐘熱處理試片氮化鎵和氧化物的 EDS 直線濃度變化曲線。(a)分析區域的 STEM BF影像;(b)EDS 內建程式計算的直線濃度變化曲線;(c)經自我校正定量法校正後的直線濃度變化曲線。[8](圖片來源:宜特科技)
▲圖八: 900ºC/20 分鐘熱處理試片氮化鎵和氧化物的 EDS 直線濃度變化曲線。(a)分析區域的 STEM BF影像;(b)EDS 內建程式計算的直線濃度變化曲線;(c)經自我校正定量法校正後的直線濃度變化曲線。[8](圖片來源:宜特科技)
本文與各位長久以來支持宜特的您分享,若您有相關需求,或是對相關知識想要更進一步了解細節,歡迎洽詢 +886-3-579-9909 分機 1067 張小姐 / Email: marketing_tw@istgroup.com。
(圖片來源:宜特科技;資料來源:宜特科技)
您可能有興趣的其他技術文章
- 第三代寬能隙半導體到底在紅什麼?
- MIM 電容元件 漏電,用這五步驟,速找異常點
- 鈷真能取代銅? 7 奈米製程晶片實測分析
- 使用 TEM 分析憶阻器(memristor)結構
- 先進製程新材料特性 就靠它來驗
- 異質整合當道 材料接合應力強度備受矚目
- 材料分析如何協助先進製程設備改善缺陷
- 四大 IC 切片手法 哪一種最適合你的樣品
參考文獻
[1] H. Hirayama, T. Yatabe, N. Noguchi, N. Kamata, “Development of 230-270 nm AlGaN-Based Deep-UV LEDs,” Electron. Commun. Jpn., 93 (3), 24–33 (2010).
[2] M. Martens, F. Mehnke, C. Kuhn, C. Reich, V. Kueller, A. Knauer, C. Netzel, C. Hartmann, J. Wollweber, J. Rass, T. Wernicke, M. Bickermann, M. Weyers, M. Kneissl, “Performance Characteristics of UV-C AlGaN-Based Lasers Grown on Sapphire and Bulk AlN Substrates,” IEEE Photonics Technol. Lett., 26 (4), 342–345 (2014).
[3] F. Mehnke, M. Guttmann, J. Enslin, Kuhn, C. C. Reich, J. Jordan, S. Kapanke, A. Knauer, M. Lapeyrade, U. Zeimer, H. Krüger, M. Rabe, S. Einfeldt, T. Wernicke, H. Ewald, M. Weyers, M.Kneissl, “Gas Sensing of Nitrogen Oxide Utilizing Spectrally Pure Deep UV LEDs,” IEEE J. Sel. Top. Quantum Electron., 23 (2), 29–36 (2017).
[4] S. M. Islam, V. Protasenko, K. Lee, S. Rouvimov, J. Verma, H. Xing, D. Jena, “DUV Emission at 219 nm from Ultrathin MBE GaN/AlN Quantum Heterostructures,” Appl. Phys. Lett., 111 (9), 091104 (2017).
[5] T. Takano, T. Mino, J. Sakai, N. Noguchi, K. Tsubaki, H. Hirayama, “Deep-Ultraviolet Light-Emitting Diodes with External Quantum Efficiency Higher than 20% at 275 nm Achieved by Improving Light-Extraction Efficiency,” Appl. Phys. Express, 10 (3), 031002 (2017).
[6] T. Y. Wang, W. C. Lai, S. Y. Sie, S. P. Chang, Y. R. Wu, Y. Z. Chiou, C. H. Kuo, J. K. Sheu, “AlGaN-Based Deep Ultraviolet Light Emitting Diodes with Magnesium Delta-Doped AlGaN Last Barrier,” Appl. Phys. Lett., 117 (25), 251101 (2020).
[7] T. U. Wang, W. C. Lai, S. Y. Sie, S. P. Chang, C. H. Kuo, J. K. Sheu J. S. Bow, “AlGaN-based Deep Ultraviolet Light-emitting Diodes with Thermally Oxidized AlxGa2-xO3 Sidewall,” J. ACS Omega, (ACS ID: ao-2022-00813q.R2) (2022).
[8] J. S. Bow, Jay Wang, W. C. Lai , T. Y. Wang, S. Y. Sie, S. P. Chang, C. H. Kuo, J. K. Sheu, “Characterization of Oxide Layers on AlGaN Based DUV LEDs by TEM/STEM Analysis” IPFA 2022 (2022).
[9] G. Cliff and G. W. Lorimer, “The quantitative analysis of thin specimens”, J. Microscopy 103, 203-207 (1975).
[10] J. H. Paterson, J. N. Chapman, W. A. P. Nicholson, and J. M. Titchmarsh, “Characteristic X-ray production cross-sections for standardless elemental analysis in EDX”, J. Microscopy 154, 1-17 (1989).
[11] D. B. Williams and C. B. Carter, in Transmission Electron Microscopy, Chapter 35, (2009)
[12] T. Oshima, T. Okuno, N. Arai et al., “Vertical sola-blind deep-ultraviolet Schottky photodetectors based on - Ga2O3 substrates,” Appl. Phy. Express, 1(1):011202 (2008).










