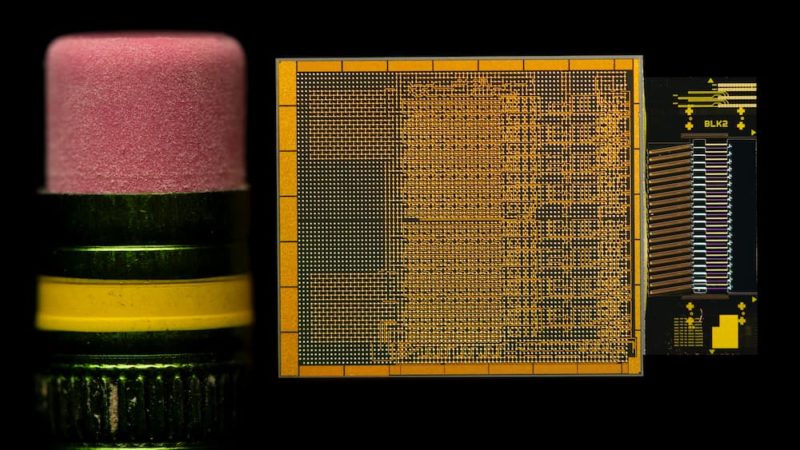
美國國防高等研究計劃署近日公布,將與德州電子研究所共同投入 14 億美元,開發以 3D 異質整合技術為基礎的美軍次世代小晶片。
德州電子研究所(Texas Institute for Electronic, TIE)成立於 2022 年,由德州大學奧斯汀分校和德州州政府、國防電子廠商和州內其他 13 所學術機構共同成立的公司,專注研究異質整合技術(Heterogeneous Integration Technology)。
DARPA 與 TIE 將以 3D 異質整合技術為基礎,開發美軍次世代小晶片,合約長度為五年,分為兩大階段,第一階段將成立隸屬於五角大廈的 Chiplet 專屬研究室和工廠,並將和 AMD、美光、英特爾、應用材料、格羅方德等美國企業共同合作。
整項計畫預算將達到 14 億美元,其中 DARPA 將負擔 8.4 億美元,德州將負擔 5.52 億美元。
由於 3D 異質整合並非全新技術,因此 DARPA 和 TIE 的這項合作,主要是為了確保美軍將有自己的獨家 Chiplet 供應來源,讓未來的武器和通訊平台開發有先進晶片可以使用。
(首圖來源:Intel)










