
隨著行動 SoC 邁入 2 奈米與高密度 AI 運算時代,散熱正成為效能競賽的關鍵變數。三星在 Exynos 2600 上導入 Heat Pass Block(HPB),近期也傳出該封裝散熱技術可能被其他 Android 陣營晶片採用,是否未來 HPB 將會成為未來手機的趨勢呢?
智慧型手機過去如何散熱?
在那之前我們先了解一下手機正常怎麼散熱的。過去幾年,旗艦智慧型手機普遍仰賴均熱板(Vapor Chamber)與石墨片等機身層級的被動散熱方案,藉由擴大散熱面積,將熱能分散至機身結構中。然而,隨著高時脈 CPU、龐大 GPU 與 NPU 同時運作成為常態,僅靠手機內部的被動散熱結構,已愈來愈難以支撐長時間高負載運算。
在此背景下,HPB 的出現,某種程度上也被視為行動裝置散熱零組件的下一種可能選項。
HPB 是什麼?把散熱結構搬進晶片封裝
Heat Pass Block 是一塊整合於晶片封裝內的金屬導熱結構,可視為微型散熱塊或熱擴散層,其位置直接設於 SoC 裸晶上方,目的在於縮短熱能從晶片核心傳導至上層散熱模組的距離。目前 HPB 主要採用銅材製作,除了具備良好的導熱效率外,在金屬材料中亦擁有相對優異的散熱表現。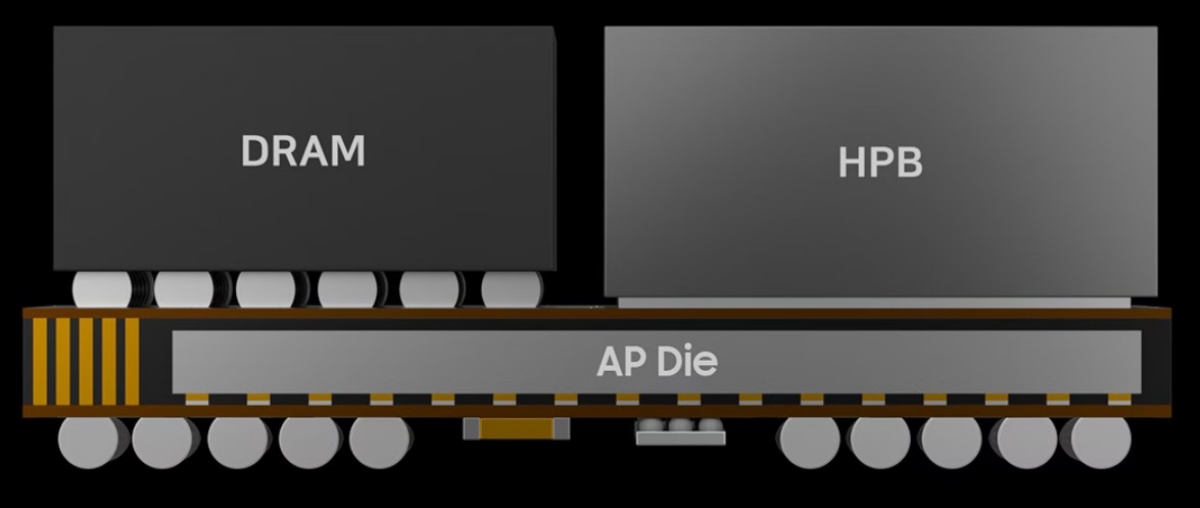
(Source:三星)
在傳統設計中,熱量需先穿過封裝材料,再由均熱板或石墨片向外擴散;而 HPB 的導入,則在裸晶與外部散熱系統之間建立更直接的熱傳路徑,使熱能能更快離開高溫區域。
三星指出,該設計可有效降低熱阻,對高功耗晶片而言,是一項相當關鍵的改善。
HPB 的現實限制與代價
儘管 HPB 帶來明確的散熱優勢,但它並非零成本方案,反而在工程與產品設計層面引入新的限制,包括體積、封裝難度與成本等問題。
首先是體積與高度。HPB 會增加封裝的 Z 軸高度,對於追求輕薄設計的手機而言,勢必壓縮其他元件,如電池或相機模組的空間配置。
其次是封裝設計的複雜度。HPB 屬於多材料結構,需同時處理金屬、封裝樹脂與裸晶之間的熱膨脹差異,對製程控制與長期可靠性提出更高要求,初期導入也可能影響良率表現。
此外,成本因素亦不可忽視。HPB 封裝需要更精細的製程與額外材料,短期內勢必僅適用於旗艦或 Pro 級 SoC,難以全面下放至中低階市場。
HPB 真的需要嗎?
從 Exynos 2600 的導入來看,Heat Pass Block 已不再只是單一散熱技術的嘗試,而是反映出行動 SoC 正跨入一個全新階段──效能瓶頸正逐步從製程微縮與架構設計,轉移到「熱能能否被即時帶走」。
相較之下,台積電目前仍維持既有的封裝與散熱設計思路,並未導入類似 HPB 的封裝內散熱結構。依現階段公開資訊來看,台積電在 2 奈米世代規劃的 WMCM(Wafer-level Multi-Chip Module)封裝,主要採用水平配置的晶粒布局,藉由拉開晶粒間距與擴大接觸面積,有助於分散熱源、降低局部熱集中問題,而非透過在封裝內直接加入金屬導熱塊來強化散熱。
這也顯示,在行動 SoC 進入高功耗與高運算密度時代後,散熱不再只有單一路徑,而是逐漸演變為封裝架構與系統設計層面的整體取捨。
(首圖來源:pixabay)










