
掃描探針顯微術(Scanning Probe Microscopy, SPM)是一種運用探針靠近樣品表面進行掃描,能呈現具有原子級高解析度的表面形貌。
1981 年出現的掃描穿隧顯微術(Scanning Tunneling Microscopy, STM),適用於導電材料,直到 1986 年後才發展出能測量導體及非導體的原子力顯微術(Atomic Force Microscopy, AFM)。關於一系列 AFM 所發展的技術如:掃描式電容顯微鏡(Scanning Capacitance Microscopy, SCM)、磁力顯微鏡(Magnetic Force Microscopy, MFM)、掃描開爾文探針顯微鏡(Kelvin Probe Force Microscopy, KPFM)、定量奈米力學顯微鏡(Quantitative Nanomechanical Microscopy, QNM)等技術應運而生,經由特殊探針搭配不同傳感器以實現多功能化的量測,如:力學特性、磁性、電性、熱性。
SPM 能應用在 IC 產業(如矽、碳化矽基板、非金屬/金屬薄膜、HEMT 結構、三五族半導體)、光電產業(如藍寶石基板、LED/LD chip、ITO 薄膜、光通訊元件、CMOS 影像感測器)、封裝產業(如 PI、錫球、Gate Pad 上彈坑、銅箔)等。
表面粗糙度與形貌|原子力顯微鏡 AFM
原子力顯微鏡可測出樣品的表面粗糙度與形貌,是利用奈米探針在樣品表面做掃描,藉由原子之間的凡得瓦爾作用力產生接觸與排斥現象、再配合探針懸臂(cantilever)作為雷射光的反射介面,而探針表面作用吸引或排斥產生雷射的偏移量,將偏移數值記錄後,即可呈現樣品的表面形貌。圖 1(左)為 HEMT 元件的 GaN 膜層表面粗糙度,得到 Z Range : 28.1 nm;Ra : 1.23 nm;圖 1(右)為 CMOS 影像感測器(CIS)的 Micro lens 斷面分析,而 CIS 的收光效果通常會受到 Micro lens 的均勻性、表面品質和厚度所影響。
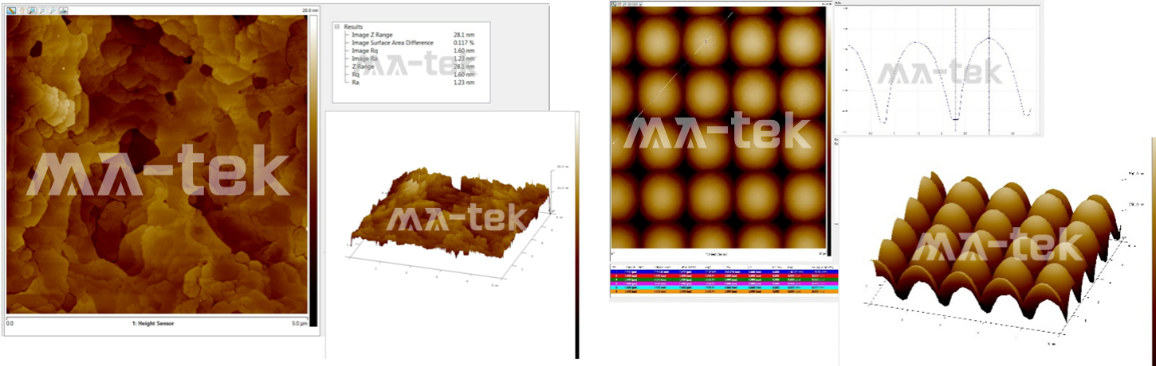
▲圖 1 GaN film 表面粗糙度(左)與 Micro lens 斷面分析(右)
摻雜分佈|掃描式電容顯微鏡 SCM
如果想得知元件的 N/P 摻雜分布、測量各區域的尺寸(如摻雜厚度、Channel length、Trench 摻雜深度、Source/Drain 大小、N/P well 界面等資訊),可以透過掃描式電容顯微鏡(SCM)來觀察二維摻雜影像,並分辨出 N 型、P 型區域,找出摻雜異常分佈導致的故障及逆向工程分析。掃描式電容顯微鏡 SCM 可彌補其它分析技術的不足,像是展阻分析儀(SRP)僅能呈現一維分布、 SEM 搭配化學蝕刻染色之分析技術不易精確控制蝕刻率等。
掃描式電容顯微鏡 SCM 技術是藉由金屬探針接觸樣品表面後,形成微小的 MOS 結構,分析時施加於金屬鍍膜探針上的 AC 電壓 (等於 MOS 的閘極電壓),導致載子的累積和耗盡、並產生電容變化,量測 dC/dV 訊號轉換為二維摻雜分布,可以分辨出 N 型、P 型區域及其界面,主要用來量測樣品的摻雜分佈。
SCM 對於摻雜濃度的偵測範圍為 E14~E20 atom/cm3,平面解析度可達 50 奈米,可應用在 IC 元件(功率電子元件、GBT/FRD、三級管器、雷射二極體、DRAM 元件、MOSFET) 和光電產業應用 (CMOS Image Sensor、VCSEL、光通訊元件、LED)。圖 2 為 SiC 三級管的失效器件之電性亮點定位,針對亮點處比較良品與不良品的 SCM 影像,發現不良品摻雜分布明顯異於良品。

▲圖 2 SiC 三級管的失效器件分析
磁區分佈|磁力顯微鏡 MFM
對於含有鐵、鈷、鎳等磁性材料的表面磁區分佈狀況,可以由磁力顯微鏡(MFM)掃描得到,原理類似原子力顯微鏡 AFM,主要差異為使用帶有磁性的探針,利用 Life Mode 方式進行磁性材料的分析,MFM 可以同時收集表面形貌、磁性訊號,從偵測樣品表面的磁力變化呈現出磁區分布,磁性探針與樣品間的長程磁力作用的振幅、頻率和相位變化皆可成像,適用於磁性薄膜、磁存儲設備和磁記錄組件。圖 3 為磁帶(左)與硬碟(右)的磁區分佈和強度影像,可從 MFM 結果了解不同的磁性記錄方式與密度。MFM 與其他磁成像技術相比,不需要特殊的樣品製備且無須破壞樣品,在大氣之下進行就能獲得高解析度。
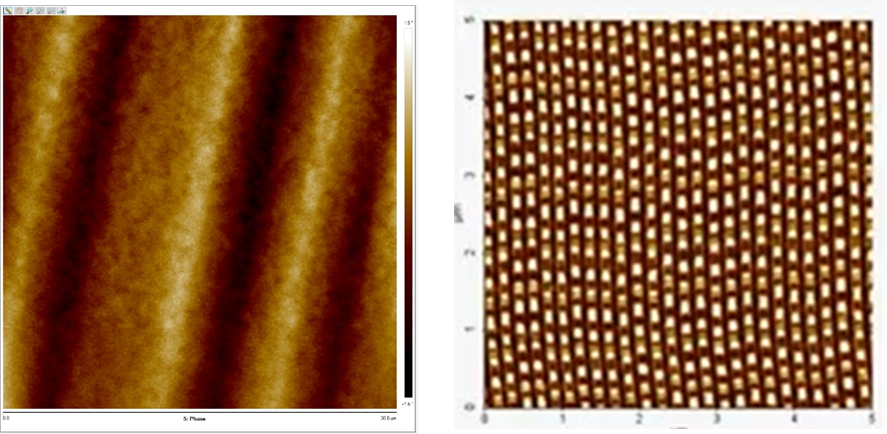
▲圖 3 磁帶(左)與硬碟(右)的磁區分佈[1]
電位能分佈|掃描電勢顯微鏡 SKPM
導體/半導體的表面電位、功函、薄膜均勻性和覆蓋率可由掃描開爾文探針顯微鏡(KPFM)來測量,又稱為掃描電勢顯微鏡(SKPM)。KPFM 屬於一種靜電力顯微鏡(Electrostatic Force Microscopy, EFM)技術,原理為探針懸臂受到交流電壓產生震動、同時外加直流偏壓來補償樣品和懸臂之間的電位差,使懸臂震幅等於零。透過檢測所需補償的電壓,即可得到表面電勢分佈。
利用 Kelvin 法來量測探針與樣品表面間的電勢差(電位能)具有高表面分辨率(奈米尺度),屬於定量測量的方式。應用如介電質層分析、金屬汙染物殘留、錫鉛焊料、腐蝕觀察、石墨烯等。圖 4 顯示分辨三種不同材料(Al、Si、Au)的表面形貌與電位能分佈。
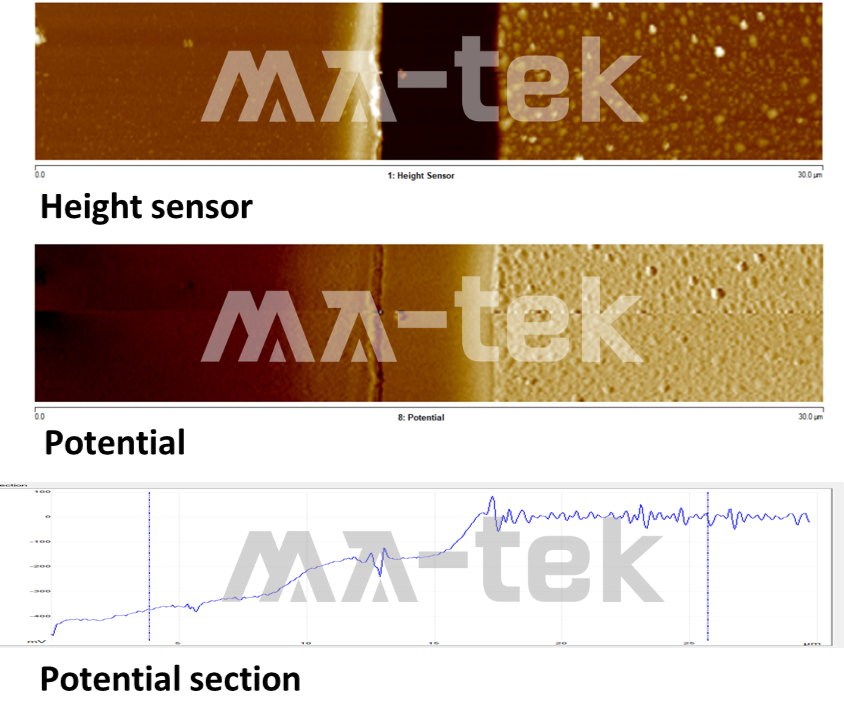
▲圖 4 Al/Si/Au 表面形貌與電位能分佈
力學分析|定量奈米力學顯微鏡 QNM
量化的奈米機械特性可由定量奈米力學顯微鏡(QNM)測得,同時取得表面形貌、機械性質力學量測的分佈。量化的機械性質(彈性模數、探針樣品間的黏性、能量損失與最大應變)來自力 — 距離曲線的最大吸力、斥力斜率與探針掃描來回過程的曲線積分面積差,經過 Derjaguin-Muller-Toporov(DMT)理論模型進行數值分析即可獲得。
QNM 能精準控制成像力道得到非破壞的高解析力影像,可處理從 1 kPa 到 100 GPa 模量、或 10 pN 至 10μN 附著力的各種樣品。應用於高分子材料、碳化鎢鋼、不鏽鋼和金屬材料等。圖 5 為高分子材料的 QNM 分析圖,顯示附著力、消散力、楊氏係數和形變量影像。
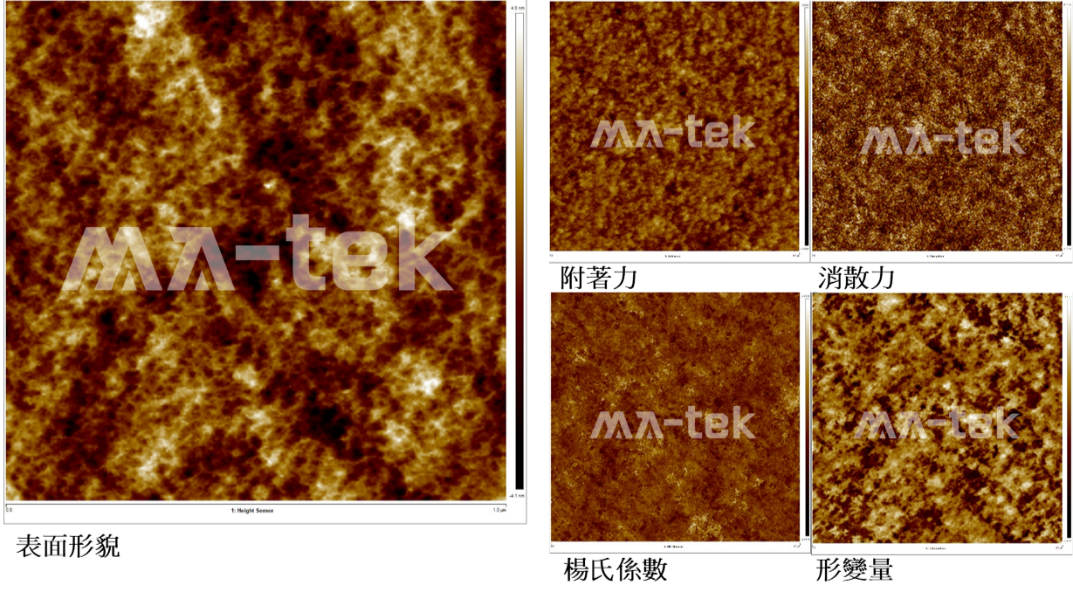
▲圖 5 高分子材料力學分析
閎康 SPM 提供樣品局部表面形貌、粗糙度量測,亦有 SCM 為 IC、光電等產業提供失效分析、逆向分析。新的技術引進 MFM、KPFM 與 QNM,可獲得樣品局部高空間分辨率(奈米尺度),是產業界 R&D 的首選夥伴。
Reference:
[1]AFM網路講座系列第三講:原子力探針顯微術基礎及其應用進展-功能化原子力探針顯微術
(首圖來源:Pexels;資料來源:閎康科技)
本網站內容著作權係屬 TechNews 或授權本網站使用之提供者所有,不得作為商業用途形式傳輸、散布或提供予公眾。










