
當半導體製程不斷微縮至 2nm,如何快速且精準量測參數,取代不足以應付工程需求的傳統量測方式,加速製程開發呢?
當半導體製程逐漸縮小至 3nm 甚至 2nm 節點(Node),精準量測每個關鍵參數,並以大數據(Big Data)技術優化生產方法,對於改善製程良率至關重要。但傳統手動量測方法效率低、誤差大,成本又高。因此,唯有透過自動量測,才能快狠準取得正確參數,持續產出大量的奈米尺度元件數據,例如:薄膜厚度(Film Thickness)、CD 值(Critical Dimensions)、電晶體結構(Transistor Structure)、表面形貌(Morphology)、摻雜濃度(Doping Concentration)與缺陷(Defect)分析,以提高產量並從中挖掘出創新商機。
那該如何透過量測統計晶粒(Grain)和奈米顆粒(Nano Particles)的大小、形狀及分布,或算出各膜層的厚度或寬度呢?本期宜特小學堂,將為您帶來,透過穿透式電子顯微鏡(Transmission Electron Microscopy;簡稱 TEM),搭配最新自動量測軟體實際應用的三大案例。
案例一:如何解決以往人工誤差,讓 FinFET 和 GAAFET 的量測數據不失真?
隨著 5G、AI 人工智慧、元宇宙快速崛起,發展低功耗、小尺寸、異質整合及超高運算速度的晶片架構技術,已成為全球半導體製造業者最重要的決勝關鍵。
現今主流使用的鰭式場效電晶體(Fin Field-Effect Transistor;FinFET),避開當初因製程縮小至 20 奈米以下,閘極長度變短衍伸出的漏電等問題。而針對「閘極長度(Gate length)」,或稱「製程線寬」,也就是電晶體中的源極(Source)到汲極(Drain)距離的精準掌握,以及對於鰭式矽晶形狀的控制度,都是影響電晶體效能的最重要因素之一。
以往傳統手動的方式,在 TEM 影像上量測閘極長度時,過程中容易因人為誤判,導致數據失真。為了有效降低人為計算所造成的錯誤,宜特材料分析實驗室以 TEM 搭配最新研發出的影像自動量測軟體,其步驟如圖一。處理一張照片只需數分鐘,即可將分析樣品的量測寬度轉換成數據圖,如圖二所示。這類分析的結果,不僅可呈現各層的單一數值,更能以統計學的方法,針對多根 FinFET 的鰭型線寬加以比較分析。
 ▲ 圖一:此影像自動量測軟體技術主要分成三個步驟。(Source:宜特科技)
▲ 圖一:此影像自動量測軟體技術主要分成三個步驟。(Source:宜特科技)
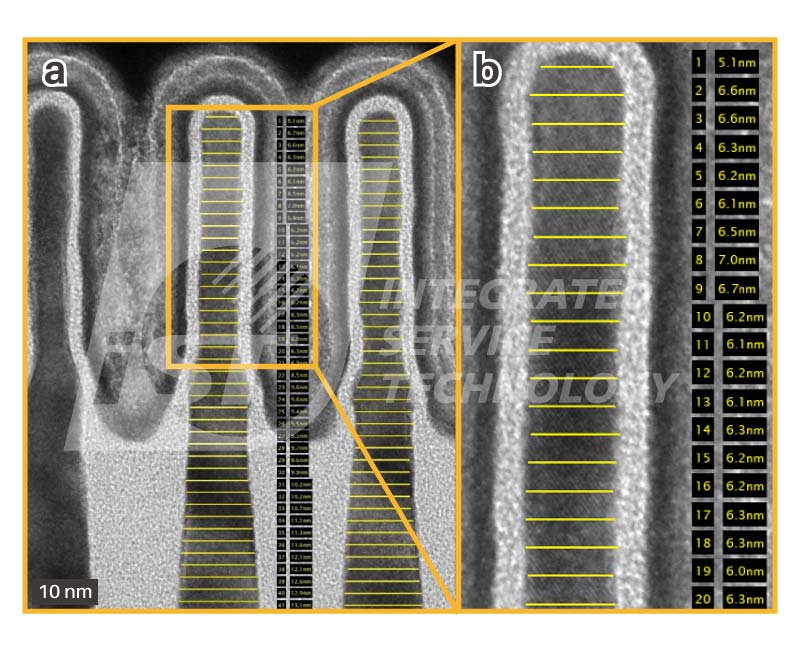 ▲ 圖二:FinFET TEM 影像自動量測軟體顯示結果。圖二(a)先框選出 FinFET 中欲量測的位置;從圖二(b)可知,每隔 2nm 軟體就能抓取到 Si Fin 邊界;圖二(c)針對多根 FinFET 的鰭型線寬統計資料。(Source:宜特科技材料分析實驗室)
▲ 圖二:FinFET TEM 影像自動量測軟體顯示結果。圖二(a)先框選出 FinFET 中欲量測的位置;從圖二(b)可知,每隔 2nm 軟體就能抓取到 Si Fin 邊界;圖二(c)針對多根 FinFET 的鰭型線寬統計資料。(Source:宜特科技材料分析實驗室)
不過,當製程繼續向下微縮至 3 奈米,甚至推進至 2 奈米節點時,FinFET 也開始面臨到漏電等物理極限。因此,全新架構的「環繞式閘極場效電晶體(Gate-All-Around FET;簡稱GAAFET)」應運而生。GAAFET 結構分為第一代奈米線型(Nanowire;簡稱 NW)和第二代奈米片型(Nanosheet;簡稱 NS)兩種形態。而 GAAFET 的晶片架構和 FinFET 不同之處,包括一開始需要以磊晶(Epitaxy;簡稱 Epi)的方式,將矽層(Si)與矽鍺層(SiGe)堆疊成奈米片磊晶(Nanosheet stack epitaxy),SiGe 做為「犧牲層」(Sacrificial SiGe)在後續的「通道釋放」(channel release)時,利用蝕刻把 SiGe 吃光來獲得一層一層的奈米線或奈米片,然後再以閘極金屬(High-k)來包覆奈米片(線),如圖三(a)所示。因此,若能精準量測 GAA 中 SiGe 和 Si 的膜厚,以及對於 SiGe 形狀的控制,就可加速 GAA 的製程改良。
宜特材料分析實驗室最新引進的影像自動軟體有三大功能:
一、可一次同時針對多個層次進行量測,並可設置達上百條量測線段。
二、量測線段間距可配合客戶需求進行調整,如圖三(b)所示,針對 SiGe/Si 各層量測可設置不同間距。
三、可立即性提供客戶量測數據,以往若是手動的方式量測,可能需花費長達一小時,透過軟體協助,可縮短至數分鐘內。
如圖三(b)所示,此影像自動軟體,因為可精準抓取到 SiGe/Si 各層的邊界,讓客戶可知 SiGe 層蝕刻後各點剩餘的厚度,並可調整其不同厚度的蝕刻參數。因此能精準掌握蝕刻後的閘極金屬形狀,進而得到勻度(Uniformity)、穩定性均佳的環繞式閘極結構,這亦是影響電晶體效能的最重要因素之一。
 ▲ 圖三:GAAFET 製程簡易示意圖。圖三(a)GAAFET 製程流程圖;圖三(b)GAAFET STEM 影像使用自動量測軟體顯示結果,軟體可抓取到 SiGe 以及 Si 各層的邊界,量測線段間距也可客製化進行調整(Source:宜特科技材料分析實驗室)
▲ 圖三:GAAFET 製程簡易示意圖。圖三(a)GAAFET 製程流程圖;圖三(b)GAAFET STEM 影像使用自動量測軟體顯示結果,軟體可抓取到 SiGe 以及 Si 各層的邊界,量測線段間距也可客製化進行調整(Source:宜特科技材料分析實驗室)
案例二:想快速得到有意義的奈米顆粒尺寸和分佈的數據分析圖?
100 nm 以下的奈米顆粒,主要應用在催化劑、感應器、電極、甚至在油漆塗料中。宜特材料分析實驗室藉由 TEM 搭配最新影像自動量測軟體,透過軟體協助可精確快速的量測出奈米顆粒的大小與形狀,再以影像處理之後的統計數據分析圖,分析奈米顆粒大小及分佈,並可同時得到多種在研發材料上所需的數值,如奈米面積、半徑、顆粒平均值、周長等等,如圖四(d),作為奈米材料研發的參考,縮短研發時間。
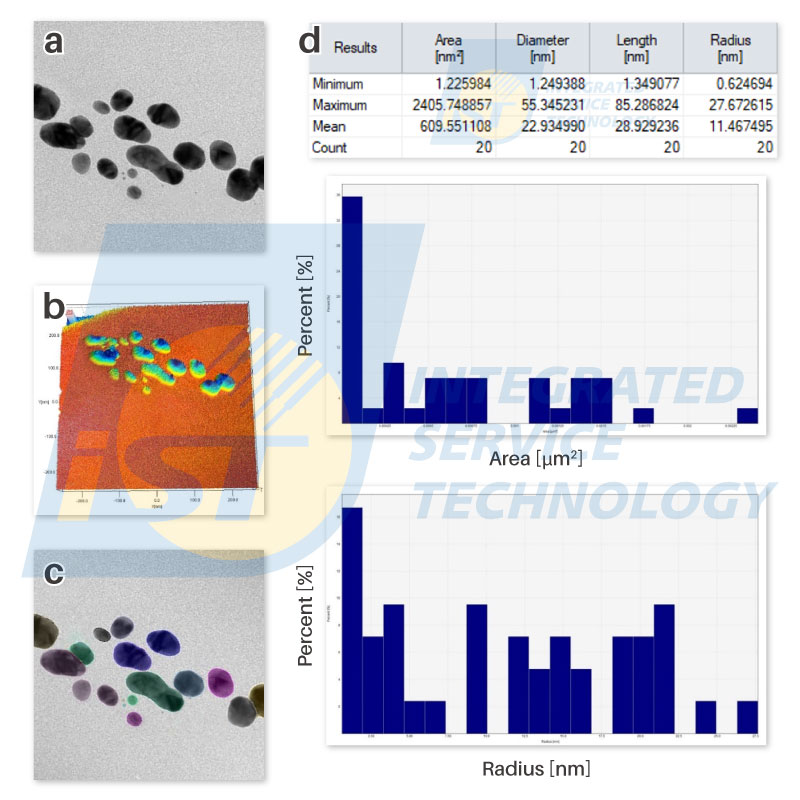 ▲ 圖四:奈米顆粒 TEM 影像自動量測軟體顯示結果。圖四(a)為奈米顆粒 TEM 影像;從圖四(b)可知軟體模擬 3D 形貌輪廓圖模型;圖四(c)軟體利用形貌輪廓圖,經過影像辨識後的奈米顆粒影像;圖四(d)為奈米顆粒影像處理之後的統計數據分析圖(Source:宜特科技材料分析實驗室)
▲ 圖四:奈米顆粒 TEM 影像自動量測軟體顯示結果。圖四(a)為奈米顆粒 TEM 影像;從圖四(b)可知軟體模擬 3D 形貌輪廓圖模型;圖四(c)軟體利用形貌輪廓圖,經過影像辨識後的奈米顆粒影像;圖四(d)為奈米顆粒影像處理之後的統計數據分析圖(Source:宜特科技材料分析實驗室)
案例三:清楚辨識出晶粒尺寸量測和分佈,如有神助
單位面積中晶粒的數量與晶粒的尺寸有關,晶粒的大小對材料的硬度、拉伸強度、韌性、塑性等機械性質都有決定性的影響。因此,若能精準的量測材料晶粒的尺寸大小,即可預先評估其材料性能。以 UBM(Under bump metallurgy;球下金屬層)的銅/鈦(Cu/ Ti)層次為例,宜特材料分析實驗室以 TEM 搭配影像自動量測軟體,可以清楚的從 Cu 晶界對比中分辨出晶粒的形狀與大小,如下圖五所示。
並且,可針對大量的晶粒做出精準的統計結果,同時得到多種在研發材料上所需的數值,如晶粒的面積、半徑、顆粒平均值、周長等等,如下圖五(b)所示。其相關數值影響 UBM 的電性、硬度、擴散、熱遷移等因素,協助客戶在世代推新的情況下,更加快速開發產品。
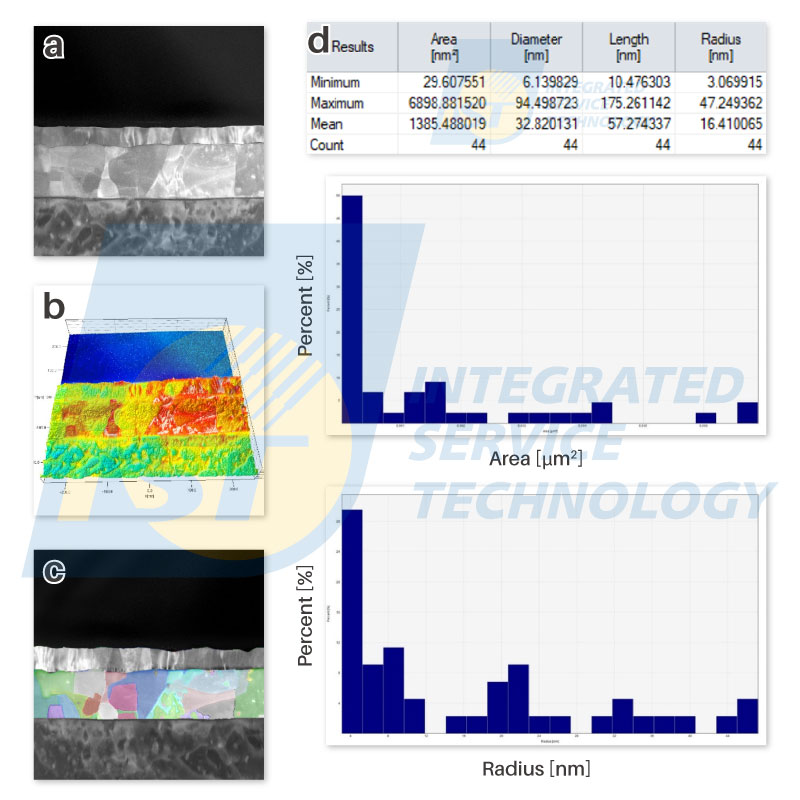 ▲ 圖五:UBM 的 Cu/ Ti 層次 STEM 影像自動量測軟體顯示結果。圖五(a)為 UBM 晶粒 STEM 影像;從圖五(b)可知軟體模擬 3D 形貌輪廓圖模型;圖五(c)軟體利用形貌輪廓圖經過影像辨識後的晶粒影像;圖五(d)為晶粒影像處理之後的統計數據分析圖(Source:宜特科技材料分析實驗室)
▲ 圖五:UBM 的 Cu/ Ti 層次 STEM 影像自動量測軟體顯示結果。圖五(a)為 UBM 晶粒 STEM 影像;從圖五(b)可知軟體模擬 3D 形貌輪廓圖模型;圖五(c)軟體利用形貌輪廓圖經過影像辨識後的晶粒影像;圖五(d)為晶粒影像處理之後的統計數據分析圖(Source:宜特科技材料分析實驗室)
本文與各位長久以來支持宜特的您,分享經驗,若您想要更進一步了解細節,歡迎洽詢+886-3-579-9909 分機1067 張小姐│Email: marketing_tw@istgroup.com
參考文獻
[1] 電子元件的靈魂-先進電晶體技術與發展趨勢| 劉致為教授
[2] K.S. Lee., et al. “Inner Spacer Engineering to Improve Mechanical Stability in Channel-Release Process of Nanosheet FETs. “June 2021; Electronics 10(12):1395.
[3] Loubet, N., et al. “Stacked nanosheet gate-all-around transistor to enable scaling beyond FinFET." VLSI Technology, 2017 Symposium on. IEEE, 2017.
(首圖來源:宜特科技;資料來源:宜特科技)
您可能有興趣的相關文章或影片
(首圖來源:宜特科技;資料來源:宜特科技。)










