
碳化矽(SiC)有望成為台灣廠商的新出海口!隨著 AI 運算帶來更高的熱能負荷,現有散熱材料已難以滿足需求,導致晶片性能下滑。半導體業界傳出,台積電正廣發英雄帖,號召設備廠與化合物半導體相關廠商參與,計劃將 12 吋單晶碳化矽應用於散熱載板,取代傳統的氧化鋁、藍寶石基板或陶瓷基板。
過去碳化矽主要應用在功率元件(Power Devices)、車用及儲能領域,如今已進入新發展階段,例如在 AR 智慧眼鏡(AR Lens)鏡片及高階 3D IC 封裝中,需要碳化矽做為散熱材料,尤其是應用在散熱載板這個部分。
其中,3D IC 封裝的碳化矽應用有兩個可能方向,首先是散熱載板,將以「導電型 SiC」優先測試;下一階段則可能在矽中介層(Silicon Interposer)導入半絕緣型 SiC。
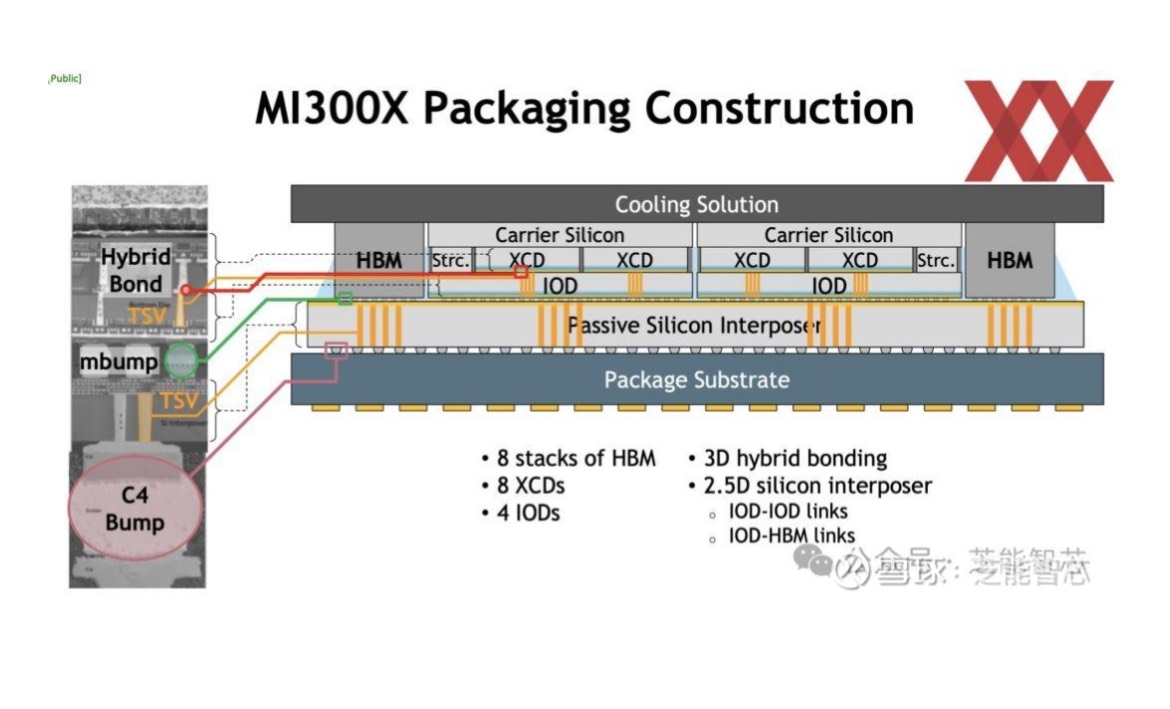
▲ 以散熱載板來說,可能是先嘗試取代圖中 Carrier Silicon 這部分。(Source:雪球、芝能智芯)
從材料特性來看,碳化矽的熱導率(K 值)僅次於鑽石。陶瓷基板的熱導率約 200~230 W/mK,而碳化矽可達 400 W/mK、甚至接近 500 W/mK。對資料中心與 AI 高運算需求而言,比傳統陶瓷更能滿足散熱需求。不過以散熱角度來說,鑽石仍是理想的最終材料,但要做到 12 吋晶圓規格,目前成本過高且技術尚未成熟。
碳化矽主要分為導電型(N 型)與半絕緣型。N 型呈現黃綠色半透明,而半絕緣型則接近全透明。供應鏈人士透露,6 吋 SiC 晶圓目前仍是主流、8 吋是未來擴產方向,而台積電要求的 12 吋 SiC 若是做為中介層使用,對結構瑕疵的要求不像傳統 SiC 那樣嚴格,但中介層的關鍵在於切割技術,如果切割技術不佳,碳化矽的表面會呈波浪狀,就無法用於先進封裝。
然而,這是否與 CoWoS 下一代延伸技術 CoPoS 還是 CoWoP 有關?目前只知道 SiC 對台積電來說可做為散熱材料。業界人士認為,碳化矽的應用會因不同的封裝技術而有所不同,未來可能會有多條發展路線,目前也有一個方向是嘗試將碳化矽應用在 PCB 上,但目前看最明確的應用仍與 AI 相關。
(首圖來源:shutterstock)










