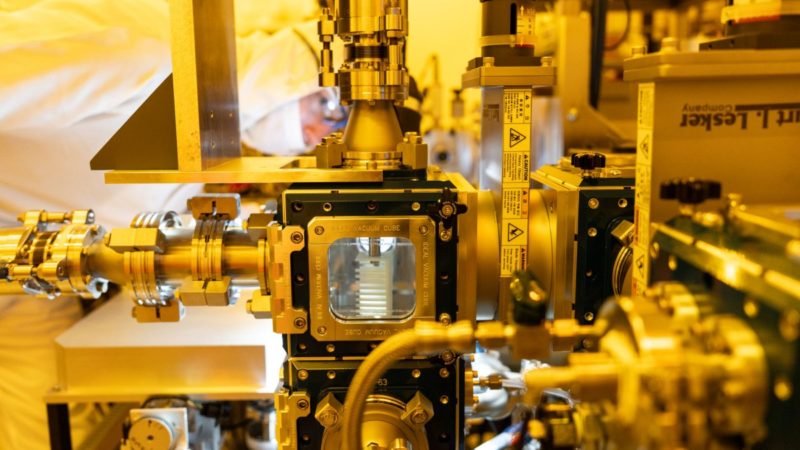
在 SPIE Advanced Lithography + Patterning Conference 上,imec 公布研究指出,若在 EUV 曝光後烘烤(Post-Exposure Bake, PEB)階段提高氧氣濃度,進而降低曝光劑量並提升 EUV 掃描機產能。
研究顯示,當曝光後烘烤環境中的氧氣濃度由大氣標準的 21% 提升至 50%,可使金屬氧化物光阻劑(metal-oxide resist, MOR)的感光速度(photo-speed)提升 15–20%。
無論是實驗模型 MOR 光阻劑或商用 MOR 光阻劑材料,都呈現一致的提升趨勢。由於 EUV 機台的處理效率與單片晶圓所需曝光劑量密切相關,劑量下降代表可在相同時間內完成更多曝光作業,對先進製程成本與產能利用率具有直接意義。
金屬氧化物光阻劑近年被視為 High NA EUV 微影的重要候選材料。相較傳統化學放大型光阻劑(chemically amplified resist, CAR),MOR 光阻劑具備更高解析度、更低線邊粗糙度,以及更佳劑量對尺寸表現,特別適合用於高解析度金屬層與薄膜光阻劑應用場景。隨著 High NA EUV 邁入量產階段,如何在維持圖形品質的同時提升曝光效率,成為製程優化關鍵。
此次成果來自 imec 開發的 BEFORCE 研究工具。該設備可在晶圓由真空曝光環境轉移至曝光後烘烤單元期間,使製程不受無塵室空氣條件影響,並透過氣體注入與混合系統精準控制烘烤環境的氣體組成,使研究團隊得以量化氧氣濃度對 MOR 光阻劑劑量響應的影響。
imec 表示,目前正透過整合式傅立葉紅外轉換光譜(Fourier-transform infrared spectroscopy,FTIR)分析曝光後烘烤過程中的化學變化,以釐清氣體環境如何影響光阻劑內部反應機制。若能建立更完整的化學模型,未來將有助於設備與材料同步優化,提升 EUV 微影的穩定度與經濟效益。
(圖片來源:Imec)










