
日本半導體材料製造商 Resonac 宣布成立由 27 間全球企業組成的聯盟「JOINT3」,目標是開發先進的晶片封裝技術。
該聯盟企業來自美國、日本、新加坡多國的材料製造商、設備供應商與晶片設計公司,如應用材料、東京威力科創。
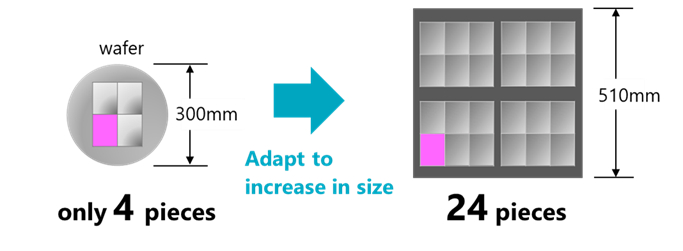
(Source:Businesswire,下同)
Resonac 在聲明中表示,聯盟將共同開發材料、設備與設計工具,用於製作以有機材料方形基板打造的中介層(interposers),並利用 515 x 510 mm 作為評估試作產線。
Resonac 半導體材料事業的技術長 Hidenori Abe 表示,JOINT3 是一個「讓材料製造商、設備供應商與設計公司實際演練,開發用於大尺寸基板製造中介層的材料、設備與技術的場域。預期這個聯盟所推出的成果,將受到眾多半導體相關公司的高度需求。

與傳統製造方式不同,以往是從圓形、非有機的矽晶圓切割出方形中介層,而 JOINT3 希望透過有機方形基板的方式,提高單位面積可生產的中介層數量,藉此降低成本。
Resonac 將在日本茨城縣設立「先進面板級中介層中心」(APLIC),將容納原型試作產線,預計 2026 年啟用。聯盟成員將透過提供貼近實際應用場景的驗證結果,加快研發進程。

Resonac 表示,這項為期五年的計畫,總投資額達 260 億日圓(約 17.4 億美元),由參與企業共同出資並營運。該公司總裁高橋秀仁(Hidehito Takahashi)指出,隨著生成式 AI 與自駕技術迅速擴展,半導體技術需求正變得日益精密與複雜,相信現在正是跨越企業與國界,共同合作的時刻。
(首圖來源:Resonac)










