
專注於 3D DRAM、3D NAND 記憶體廠 NEO Semiconductor 發表最新 3D X-AI 晶片技術,取代目前用於 AI GPU 加速器的 HBM。
據悉,這款 3D DRAM 內建 AI 處理功能,使處理和生成不需要數學運算輸出,當大量資料在記憶體與處理器間傳輸時,可減少資料匯流排(Data Bus)問題,提升 AI 效能與效率。
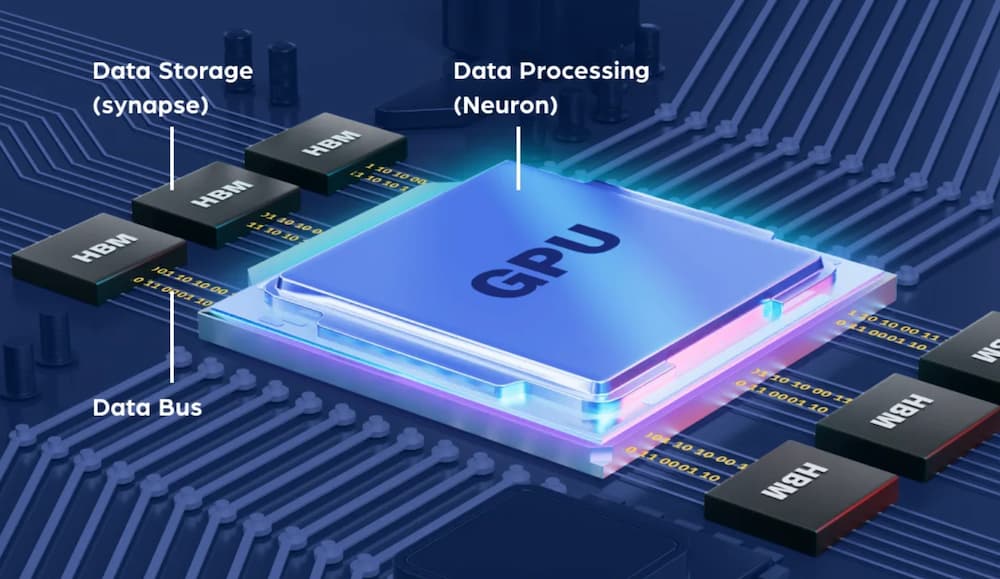
3D X-AI 晶片的底層有個神經元電路層,可處理同一晶片上 300 個記憶體層所儲存的資料。NEO Semiconductor 表示,由於 8,000 個中子電路(neutron circuits)可在記憶體中進行 AI 處理,該 3D 記憶體效能可提升 100 倍,記憶體密度比目前 HBM 高 8 倍,透過減少在 GPU 中處理的資料量,可降低 99% 耗電量。
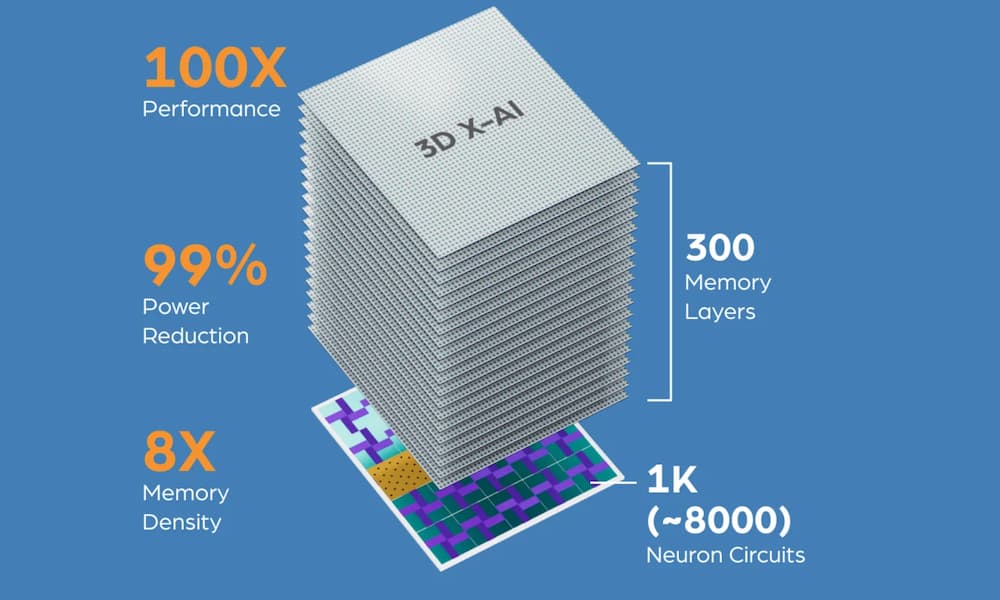
NEO Semiconductor 創辦人兼執行長許富菖指出,由於架構和技術低效率,目前 AI 晶片浪費大量效能和電力。目前 AI 晶片架構是將資料儲存在 HBM、GPU 負責執行所有運算,這種架構將資料儲存與處理分離,使資料匯流排成為無法避免的效能瓶頸,當大量傳輸資料時效能有限,耗電量也非常高。
3D X-AI 可在每個 HBM 晶片中執行 AI 處理,大幅減少 HBM 與 GPU 之間傳輸的資料,提升效能並大幅降低功耗。

X-AI 容量為 128GB,每個晶片可支援 10 TB/s 的 AI 處理能力。將 12 個裸晶(X-AI)堆疊在單一 HBM 封裝中,可實現超過 1.5 TB 儲存容量和 120 TB/s 處理吞吐量。
目前許多公司研究能提高處理速度和通訊吞吐量的技術,當半導體速度越來越快、效率越來越高時,在元件之間傳輸資料的匯流排將成為瓶頸,因此這樣的技術將可讓所有元件一起加速。
台積電、英特爾、鎧俠等公司都在研究光學技術,以加快主機板內的通訊速度,透過將部分 AI 處理從 GPU 轉到 HBM,NEO Semiconductor 可降低工作量,使效率遠高於目前耗電的 AI 加速器。
(首圖來源:NEO)










