
根據最新市場消息指出,晶片大廠高通(Qualcomm)極可能在其下一代旗艦處理器中,導入競爭對手三星(Samsung)所開發的創新散熱技術 HPB,以解決日益嚴峻的晶片散熱問題。
消息來源指出,三星獨家的 HPB 技術將被「許多普遍採用 Android 晶片的製造商」所採用,而這項預期在近期獲得了進一步的證據支持。一份疑似為高通代號「SM8975」晶片的封裝示意圖流出,圖中顯示高通似乎正在將三星設計的 HPB 模組整合到其下一代 Snapdragon 行動平台中。根據外界推測,這款代號「SM8975」的晶片,極有可能是傳聞中的 Snapdragon 8 Elite Gen 6 Pro。
至於,為何高通願意採用「宿敵」三星的技術?主要原因在於現有的散熱方案已難以壓制頂級晶片的高溫。報導指出,儘管高通近期的旗艦處理器在基準測試(Benchmark)中表現亮眼,但這些先進晶片似乎已達到了熱散的物理極限。也就是即便是搭配了成本高昂的散熱板(Vapor Chamber)冷卻系統,仍難以完全解決高高效能帶來的過熱挑戰。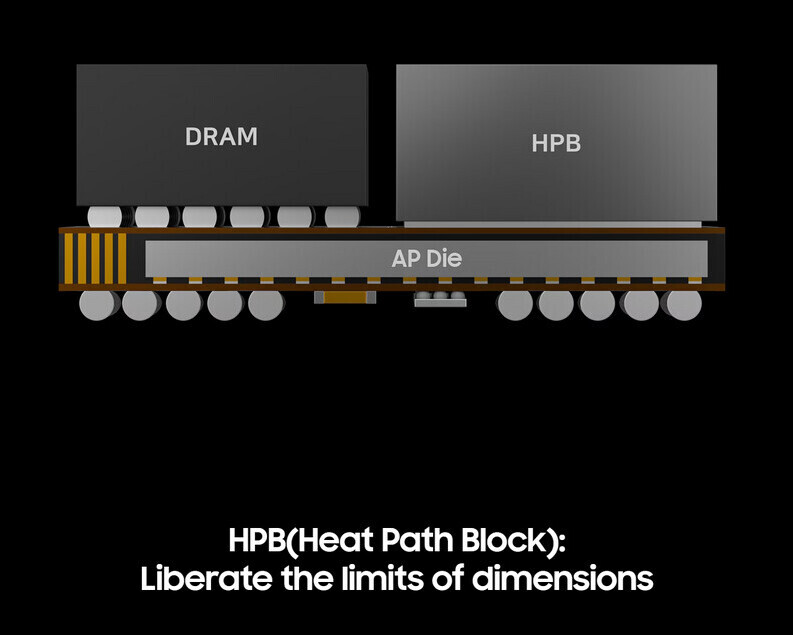
而三星晶圓代工(Samsung Foundry)所開發的 HPB 技術,提供了一個全新的解法。與傳統堆疊封裝方式不同,HPB 的設計特點在於將散熱塊直接置於晶片裸晶(Die)上方並保持接觸,關鍵在於它移除了通常位於上方、會阻擋熱量散發的 DRAM 層。在三星的設計示意圖中顯示,DRAM 被移至側面,從而消除了阻礙熱量傳導的障礙,讓散熱器能更直接、高效地將熱量導出。
消息來源強調,這項技術最初是三星為其剛推出的 2 奈米製程 Exynos 2600 處理器所量身打造的先進技術。然而,為了追求極致效能與穩定的溫控,高通顯然認為這項技術值得借鑑。早於2025 年底,便有多篇新聞報導指稱,除了三星自家使用外,高通與蘋果(Apple)將是 HPB 技術的兩大主要外部採用者。
若消息屬實,這將標誌著高通在解決旗艦晶片發熱問題上的一次重大策略轉向,直接借用競爭對手的關鍵散熱設計,以確保下一代 Snapdragon 8 Elite Gen 6 Pro 能在維持高性能的同時,不再受制於過熱降頻的困擾。
(首圖來源:高通)










