
寬能隙半導體大躍進,面對具有特殊結構且高功率密度的氮化鎵晶片,如何突破故障分析的盲點讓缺陷現形?
寬能隙半導體(Wide Band Gap semiconductors)如氮化鎵(Gallium Nitride,簡稱 GaN)與碳化矽(Silicon Carbide,簡稱 SiC),是近年熱門的化合物半導體材料,又稱為第三類半導體。
相對於以往第一類(矽)與第二類(GaAs, InP)半導體,第三類半導體因具有寬能隙、低漏電、耐高電壓及高溫等特性,且其能源轉換效率更好,因此普遍被應用於功率元件。而氮化鎵元件可支援更高的開關切換頻率,並提供極佳的功率密度,在相同電氣性能下,可有效縮減整體系統的尺寸,通常被應用於中功率、中壓(50V 至 900V)產品。至於 SiC 元件則適用於高功率、高壓(1,000V 以上)的相關應用。
以氮化鎵電晶體為例,目前已廣泛應用於手機和筆電等消費性電子產品的快速充電市場上,同時,資料中心(Data center)需求的快速成長,也成為氮化鎵電晶體的另一個重要應用領域。再加上,未來隨著各國陸續禁售燃油車,車載充電器(On Board Charger,簡稱 OBC)和電動車 DC-DC 轉換器等應用,也將成為氮化鎵電晶體大放異彩的舞台。這一趨勢表明,氮化鎵電晶體不但將成為眾多汽車製造商爭相角逐的焦點領域,亦正逐步展現出廣泛的市場潛力。
本期宜特小學堂,我們將先介紹常用的功率電晶體兩大結構,再進一步分享如何透過宜特的獨家手法,定位出氮化鎵電晶體晶片異常點,有效提高物性故障分析時找到缺陷的機率,讓你擺脫找不出異常點的困擾,加速產品的驗證與良率的有效提升。
一、兩大主流功率電晶體架構介紹
現今常用的功率電晶體架構,可概分為兩大類,(一)垂直式結構 ; (二)水平式結構。
(一)垂直式結構 (Vertical structure)
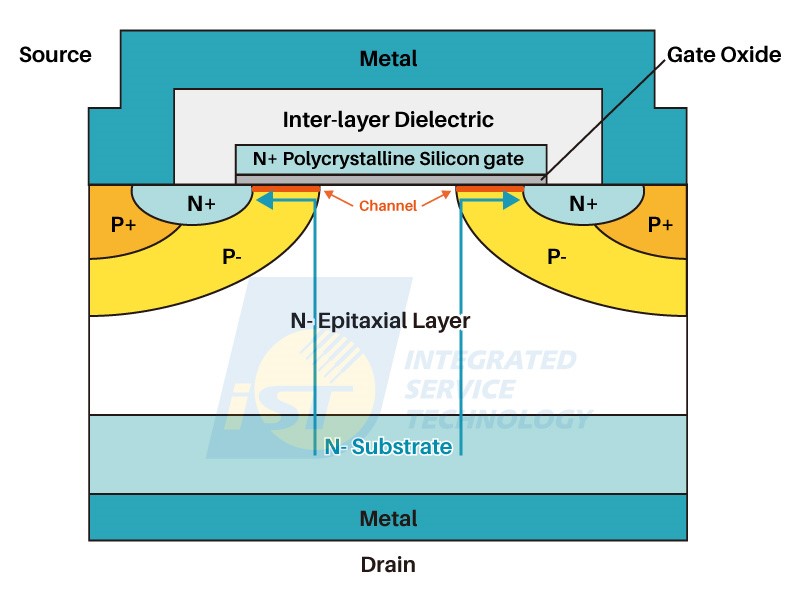 ▲圖一:垂直式 Power MOSFET 結構示意圖(Source:A Review on Power MOSFET Device Structures, International Journal of Applied Science and Engineering, 2017)
▲圖一:垂直式 Power MOSFET 結構示意圖(Source:A Review on Power MOSFET Device Structures, International Journal of Applied Science and Engineering, 2017)
一般 Si 與 SiC 普遍使用的垂直式功率 MOSFET 結構(Vertical Double-diffused MOSFET,簡稱VDMOS),在此結構中,電流路徑如圖一藍線所示。為了改善其電氣特性,常用手法包括採用特殊的溝槽式閘極(Trench Gate)設計,以及減薄晶圓厚度等方式。
(二)水平式結構
水平式功率 MOSFET 結構(Lateral Double-diffused MOSFET,簡稱 LDMOS),通常被廣泛應用於矽基材的電晶體中;而本文重點氮化鎵高電子移動率電晶體(High Electron Mobility Transistor,簡稱 HEMT)亦採用該類 LDMOS 的結構,示意圖如圖二。
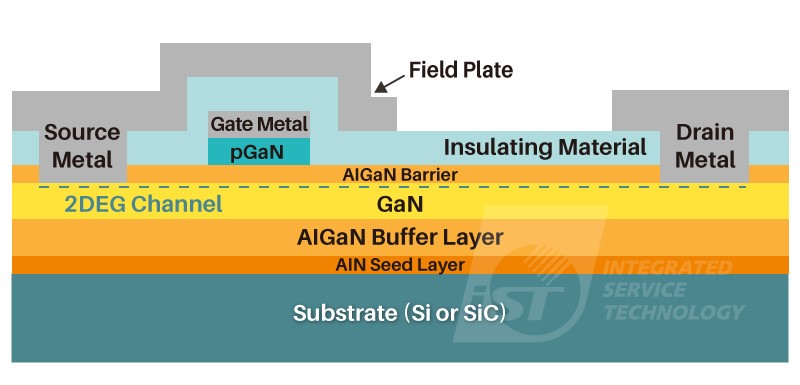 ▲圖二:GaN 水平式 HEMT 結構示意圖(Source:Lidow, A., Beach, R., Nakata, A., Cao, J., and Zhao, G.Y.(2013). US Patent 8,404,508, 26 March 2013.)
▲圖二:GaN 水平式 HEMT 結構示意圖(Source:Lidow, A., Beach, R., Nakata, A., Cao, J., and Zhao, G.Y.(2013). US Patent 8,404,508, 26 March 2013.)
目前市場主流為 GaN-on-Si 架構,利用氮化鎵磊晶和金屬導線等相關製程,將P型摻雜氮化鎵的閘極(Gate),與源極(Source)和汲極(Drain)實現於矽基板(Si Substrate)之上,這種結構有以下優點:
- 可與標準的矽晶圓製程相容,製程更具彈性化使之可於一般晶圓廠閒置產能進行量產,成本隨之更加親民。
- 在 GaN 和 AlGaN 之間形成的二維電子氣(2-Dimensional Electron Gas, 2DEG)異質界面,具有非常高的電荷密度和遷移率,這樣的組合有效降低 RDS(on) 並提高元件的運算速度。
- 利用 P 型 GaN 進行二維電子氣通道的阻斷設計,使原先常開模式(Normally Open)元件改變為增強型(enhance mode)的常閉模式(Normally Off),其與 Si MOSFET 的驅動方式類似,以方便設計者使用。
- 該結構無閘極氧化物可提供高閘極可靠性。
二、氮化鎵(GaN)與一般矽元件在故障分析上的差異
由於上述這類型的氮化鎵晶片結構在閘極端附近的設計相對複雜,通常會使用不同型式的場板(Field Plate,簡稱 FP)設計,用來降低峰值電場和界面陷阱(Interface trap),並利用在最上層設計的線路重佈層(Redistribution Layer,簡稱 RDL),使晶片擁有最佳的電氣特性。一如一般故障分析手法,在進行破壞性分析前,需要先透過特性電流曲線的量測,了解該晶片的電性異常模式,如:汲極飽和電流(Drain-source Saturation Current,簡稱 IDSS)、閘極漏電流(Gate-Source Leakage Current,簡稱 IGSS)或功能測試確認電性異常條件後,再針對該電性異常進一步進行亮點(Hot Spot)故障分析,以鎖定目標。
然而,由試片正面進行亮點故障分析時,往往容易因為場板及常見的 RDL 的特殊結構造成亮點容易被遮蔽,也導致難以發現位於場板或閘極下方的缺陷。因此,宜特故障分析實驗室會建議客戶進行背面熱點定位,為使觀測解析度更加提升,首先會移除 GaN 磊晶材質下方的基板,再直接利用光學顯微鏡(Optical Microscope, 簡稱 OM)進行觀測,其解析度比紅外線光學顯微鏡(Infrared Ray Optical Microscope,簡稱 IROM)穿透基板觀測提升許多,異常亮點通常在此時都會現出蛛絲馬跡,之後再搭配背向 DB-FIB 或 TEM 切片分析,即可讓缺陷點無所遁形,客戶也因此可以有明確的改善預防措施。
三、宜特獨家基板移除技術,背向分析提升故障分析成功率
接著,我們將不藏私地分享宜特故障分析實驗室如何運用獨家手法找出 GaN 晶片的故障點。主要四項步驟如下:
(一)先透過電性量測分析,從正面定位出故障點。
(二)再運用宜特獨家手法移除磊晶材質下的基板,並從晶片背面更精確定位出故障點。
(三)大幅收斂異常區域後,即可用光學顯微鏡(OM)直接觀察異常點(Defect)。
(四)最後可再接續背向 DB-FIB 或 TEM 來對異常點(Defect)做切片分析,進一步釐清實際失效原因。
補充說明:除了以上四步驟所述的宜特獨家背向分析之外,亦可視需求採用 Nano-Prober 在晶片正面取得精準定位,再用 DB-FIB 或 TEM 切片分析。另外,因各家晶圓廠使用的基板材質有所不同,所以步驟(一)和(二)的順序,可依實際試片狀況與客戶需求進行前後交換。流程圖如圖三。
 ▲圖三:宜特故障分析實驗室運用獨家手法找出 GaN 晶片的故障點。(Source:宜特科技)
▲圖三:宜特故障分析實驗室運用獨家手法找出 GaN 晶片的故障點。(Source:宜特科技)
步驟一:電性量測分析及故障點定位
當氮化鎵晶片產生電性故障如短路(Short)、漏電(Leakage)、高阻值(High Resistance)或是功能失效(Function Failure)時,可依據不同的電性失效模式,經由直流通電或上測試板通電,並透過適合的亮點(Hot Spot)故障分析工具進行定位,包括雷射光束電阻異常偵測(Optical Beam Induced Resistance Change,簡稱 OBIRCH)、熱輻射異常偵測顯微鏡(Thermal EMMI)、砷化鎵銦微光顯微鏡(InGaAs),請見表一。藉由故障點定位設備找出可能的異常熱點(Hot Spot)位置,以利後續的物性故障分析(Physical Failure Analysis,簡稱 PFA)。(延伸閱讀:CIS 晶片遇到異常 求助無門 怎麼辦)
 ▲表一:各電性量測分析設備的使用時機表。(Source:宜特科技)
▲表一:各電性量測分析設備的使用時機表。(Source:宜特科技)
 ▲圖四:OBIRCH 熱點分析影像,可在上方發現異常亮點。(圖片來源:宜特科技)
▲圖四:OBIRCH 熱點分析影像,可在上方發現異常亮點。(圖片來源:宜特科技)
 ▲圖五:Thermal EMMI 熱點分析影像,可在上方發現收斂亮點。(圖片來源:宜特科技)
▲圖五:Thermal EMMI 熱點分析影像,可在上方發現收斂亮點。(圖片來源:宜特科技)
 ▲圖六:InGaAs 熱點分析影像,可在上方發現收斂亮點。(圖片來源:宜特科技)
▲圖六:InGaAs 熱點分析影像,可在上方發現收斂亮點。(圖片來源:宜特科技)
步驟二:宜特獨家技術移除磊晶材質下的基板與精確故障點定位
傳統所用的基板材料是以低摻雜的矽基板為主,紅外線顯微鏡可以穿透,只需依照一般的背向分析方式即可進行。然而隨著科技日新月異,基板的材料也與日俱進,例如重摻雜的矽基板、氮化鋁(AlN)(如氮化鎵矽基板廠 Qromis 開發出的 QST 基板)等陶瓷材料基板也隨之出現,這些基板都是紅外線顯微鏡無法輕易穿透的,造成背向亮點定位分析的瓶頸。
為因應此問題,宜特科技獨家研發出新式基板移除技術,針對各類基板移除並進行過程優化,可精準且均勻地移除各類基板並且順利完成高精確度的故障點定位。
步驟三:針對熱點區域用光學顯微鏡直接觀測異常點
在晶片上有了準確的定位後,便可大幅縮小須檢視的區域。接著用高解析度光學顯微鏡檢查,此時往往就能發現故障點的蛛絲馬跡,如圖七所示,可以成功進行定位。
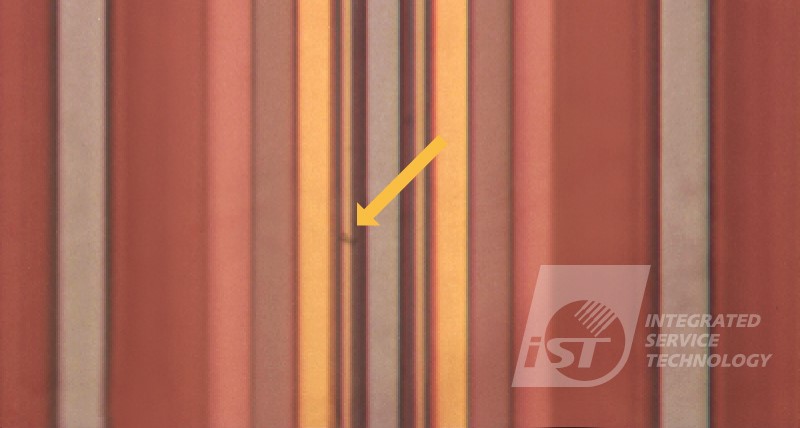 ▲圖七:使用針對熱點區域用光學顯微鏡直接觀測異常點。(圖片來源:宜特科技)
▲圖七:使用針對熱點區域用光學顯微鏡直接觀測異常點。(圖片來源:宜特科技)
步驟四:背向 DB-FIB 或 TEM 切片分析,順利找到異常點
不論是在光學顯微鏡下發現疑似異常點,或是已經有準確的熱點定位,接下來都可以進行背向雙束聚焦離子束(Dual-beam FIB,簡稱 DB-FIB)與穿透式電子顯微鏡(Transmission Electron Microscopy,簡稱 TEM)切片分析,來對異常點進行結構確認,以進一步釐清失效原因(圖七)。
 ▲圖八:DB-FIB 切片分析(左圖)和 TEM 分析(右圖),可以發現結構細部出現異常。(圖片來源:宜特科技)
▲圖八:DB-FIB 切片分析(左圖)和 TEM 分析(右圖),可以發現結構細部出現異常。(圖片來源:宜特科技)
補充說明:在步驟一之後,亦可使用 Nano-Prober 在正面取得精準定位,並用 DB-FIB 或 TEM 切片分析
除了宜特獨家的背向亮點定位之外,在某些特殊情況下,無法透過上述電性機台定出異常點位置時,也可使用奈米探針電性量測(Nano-Prober)在樣品的正面進行異常點定位分析,包括電子束感應電流(Electron Beam Induced Current,簡稱 EBIC)、電子束吸收電流(Electron Beam Absorbed Current,簡稱 EBAC)、與電子束感應阻抗偵測(Electron Beam Induced Resistance Change,簡稱 EBIRCH)等定位法(圖八)(延伸閱讀:名針探精準定位 讓奈米電性量測找出缺陷)。而 Nano-Prober 亦可針對電晶體進行電性量測,以獲取如 Vt、IdVg、IdVd 等基本參數。
當透過上述分析手法精準找到異常點後,亦可再透過 DB-FIB 或是 TEM 來對異常點進行結構確認。
 ▲圖九:EBIRCH 異常點定位分析,可以更精確的鎖定異常點位置,以利後續執行 DB-FIB or TEM。(圖片來源:宜特科技)
▲圖九:EBIRCH 異常點定位分析,可以更精確的鎖定異常點位置,以利後續執行 DB-FIB or TEM。(圖片來源:宜特科技)
宜特科技以獨家基板移除技術從樣品的背面定位出熱點,解決了 GaN 晶片故障分析的困難,並结合電性量測和物性故障等一站式分析,成功提升故障點定位率。此突破有助 GaN 技術在多個應用領域快速發展,帶來高效能和可靠的半導體元件。
本文與各位長久以來支持宜特的您分享經驗,若您想要更進一步了解細節,歡迎洽詢 +886-3-579-9909 分機 6758 鄭先生│Email:IST_FA_IAD@istgroup.com;marketing_tw@istgroup.com
(文章來源:宜特科技;首圖來源:宜特科技)










