
全球半導體設備大廠艾司摩爾(ASML)日前在一場公開活動中,公布了其新一代高數值孔徑極紫外光(High-NA EUV,HNA)微影技術的最新進展與市場採用狀況,目的在消除市場對其技術成功性的疑慮。而且,ASML 也宣布,已在總部設立 HNA 專門組織並投入運作。
針對外界質疑HNA可能不會成功的市場傳聞,ASML提供了公開數據以佐證其技術的迅速發展。最新量產型的HNA機台,型號為5200來取代早期系統,並已於2025年第二季交付給客戶。當前,HNA機台的實際應用量正呈現指數型成長。截至2025年9月份,使用HNA機台進行曝光的晶圓數量已累計超過35萬片。
ASML表示,HNA技術的核心優勢在於其效率和成本節省。若使用傳統的Low-NA EUV (LNA) 技術,要鋪設某些圖案可能需要經過三次LNA曝光步驟。然而,若使用HNA,實際上可以用一次互工的方式,取代原本的三張光罩或三次曝光。這項改進帶來了顯著的省時和省成本效益。此外,HNA能夠實現過去相當難做的「2D大圖案」(2D big pattern)曝光。傳統曝光方式通常限制在1D(直線或橫線)的圖案,而HNA的出現使得2D圖案的曝光成為可能。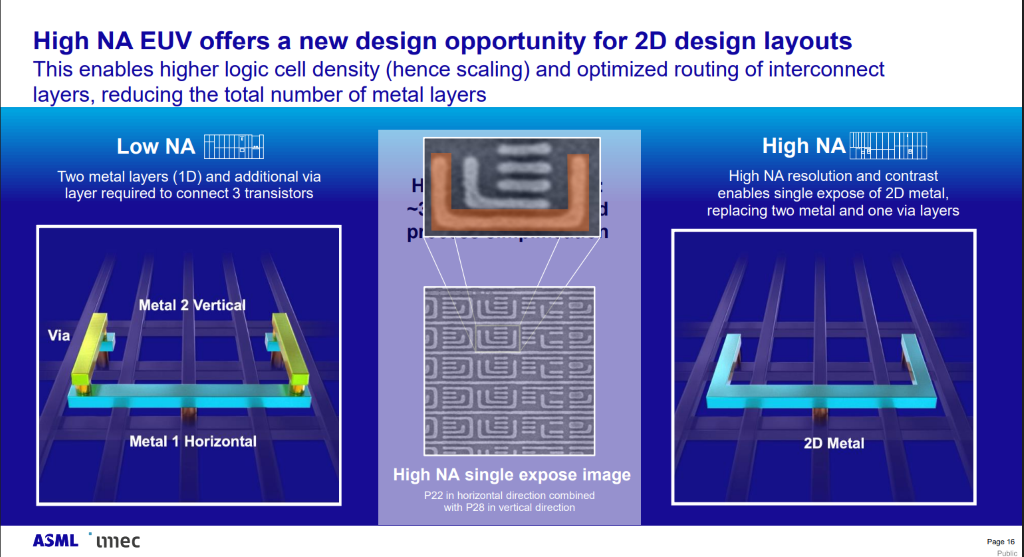
而在客戶採納方面,ASML透露,包括Intel、IBM以及三星等多家主要半導體製造商正在使用HNA。其中,Intel的公開聲明指出,HNA在瑕疵率(defectivity)和良率(yield)上,基本上已做到與LNA相同的水平。鑑於HNA目前仍處於初期發展階段,這顯示其具有實現更好性能的巨大潛力。ASML對HNA的市場採用情況表示非常有信心。
ASML指出,HNA與LNA之間最主要的設計差異在於鏡片或鏡面的設計。HNA通過減少鏡面數量來優化系統。這一設計至關重要,因為每一次光線在鏡面上的反射都會導致光源損耗,例如100的光源進入後,第一次反射可能只剩90,再出來可能只剩81,損耗不斷累積。因此,鏡面數量越少,對系統性能的表現越有利。另外,EUV光線本身具有特殊性,它無法在空氣環境中存在,因為會被空氣吸收。因此,EUV設備中的所有光學元件(鏡子)表面都經過多層處理,大約鍍有80層材料以減少損耗。
EUV光學系統對精度的要求達到了極致。鏡面的精度(accuracy)需要控制在20皮米(picometer)的等級,即千分之一奈米。為了說明這種精度的概念,如果將EUV鏡子放大到像德國這麼大,其最高點與最低點之間的差距仍會小於0.1毫米(實際上是0.00幾毫米,極其微小)。在微觀世界中,有一個不變的法則:越小的東西越難製作。而值得注意的是,EUV曝光機(無論LNA或HNA)採用的是反射式系統。光線無法穿透鏡子。與之對比,所有DUV(深紫外光)技術的世界中,則採用透射式(折射)設計,光線會穿透過透鏡。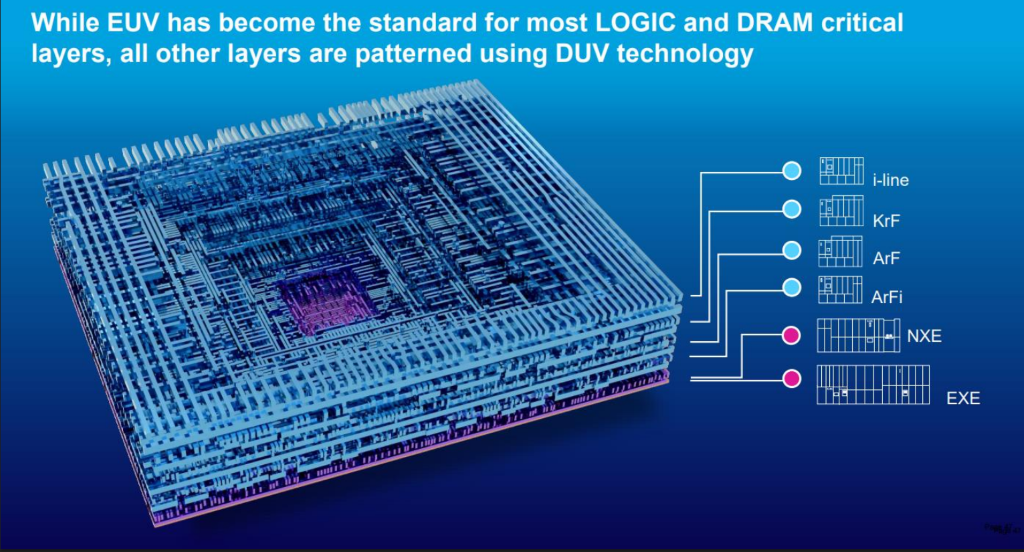
儘管EUV技術在處理晶片底部最關鍵的結構上至關重要,但從總體曝光量(Volume)來看,絕大部分的晶圓處理仍是透過DUV(深紫外光)進行曝光的。根據統計,雖然EUV的重要性日益增加,但從2024年的佔比來看,EUV仍然只佔整個晶圓曝光量中的一小塊。DUV和其他產品線的經濟效益對ASML而言至關重要,因為客戶很大一部分的生產成本仍然集中在DUV這一塊。
所以,ASML的DUV產品線持續升級。首先在浸潤式(Immersion)微影部分,最新機台為2150。該機台的性能顯著提升,每小時晶圓處理量(WPH)可達到約310片。其機對機套準(MCH machine overlay)相較前一代也有顯著提高。另外,也開發出KRF DUV機台。因為KRF DUV仍是非常重要的機台,已於2024年底開始出貨。其生產效率更高,WPH可超過400片/小時,速度極快。
ASML強調,DUV與EUV在實際生產中需要相互配合。一片邏輯晶片大約需要進行70次左右的曝光,其中可能十幾片使用EUV,而剩下的則使用DUV。因此,所有層次之間都需要進行精準的匹配(matching factor),這涉及到精確的套準(overlay),其精度皆以奈米為單位計算。無論是單機的套準(overlay)、機對機的套準,最終全部加總起來的結果就是產品上的套準(on product overlay),確保了晶片結構的精準疊加。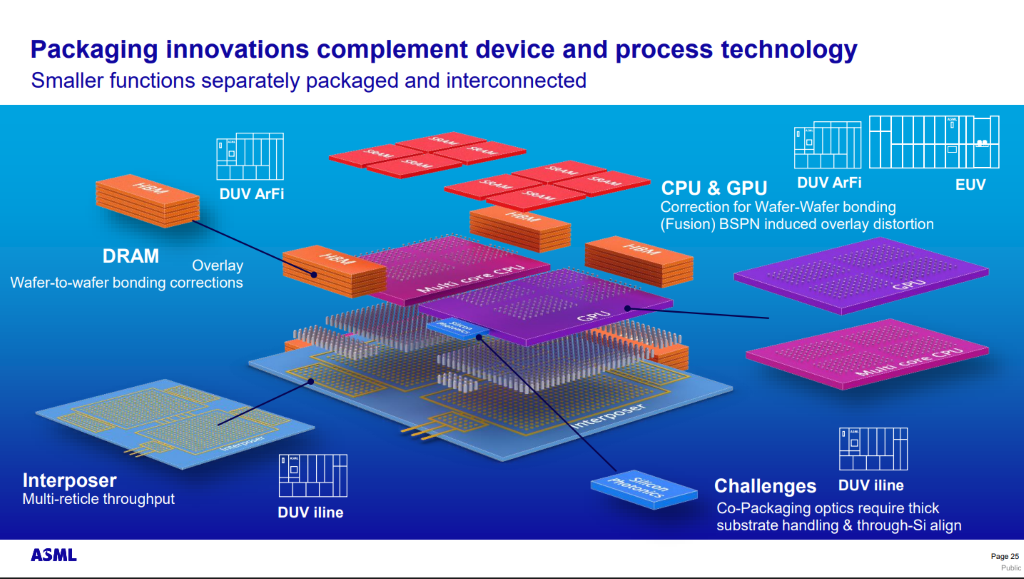
整體來說,ASML的高數值孔徑EUV(HNA)正迅速從研發走向商業化,提供了更高的效率和先進的圖案化能力。然而,深紫外光(DUV)技術因其龐大的產能佔比和成本效益,在晶片製造流程中仍然扮演著不可或缺的多數角色。半導體製造業正處於EUV引領極致微縮,同時DUV承擔大量生產的雙軌並行階段。
(首圖來源:ASML)










